แม้ว่าแผ่นเวเฟอร์ซิลิคอนและแก้วจะมีเป้าหมายร่วมกันคือการ "ทำความสะอาด" แต่ความท้าทายและรูปแบบความล้มเหลวที่พวกมันเผชิญระหว่างการทำความสะอาดนั้นแตกต่างกันอย่างมาก ความแตกต่างนี้เกิดจากคุณสมบัติของวัสดุและข้อกำหนดเฉพาะของซิลิคอนและแก้ว รวมถึง "ปรัชญา" การทำความสะอาดที่แตกต่างกันซึ่งขับเคลื่อนโดยการใช้งานขั้นสุดท้ายของวัสดุแต่ละชนิด
ก่อนอื่น ขอชี้แจงให้ชัดเจนก่อนว่า เรากำลังทำความสะอาดอะไรกันแน่ และมีสารปนเปื้อนอะไรบ้าง?
สารปนเปื้อนสามารถแบ่งออกได้เป็น 4 ประเภท:
-
สารปนเปื้อนอนุภาค
-
ฝุ่นละออง อนุภาคโลหะ อนุภาคอินทรีย์ อนุภาคขัดถู (จากกระบวนการ CMP) เป็นต้น
-
สารปนเปื้อนเหล่านี้สามารถก่อให้เกิดข้อบกพร่องในรูปแบบวงจร เช่น ไฟฟ้าลัดวงจรหรือวงจรเปิด
-
-
สารปนเปื้อนอินทรีย์
-
รวมถึงสารตกค้างจากโฟโตเรซิสต์ สารเติมแต่งเรซิน น้ำมันจากผิวหนังมนุษย์ สารตกค้างจากตัวทำละลาย ฯลฯ
-
สารปนเปื้อนอินทรีย์สามารถก่อตัวเป็นชั้นปิดกั้นที่ขัดขวางกระบวนการกัดกร่อนหรือการฝังไอออน และลดการยึดเกาะของฟิล์มบางอื่นๆ
-
-
สารปนเปื้อนไอออนโลหะ
-
ธาตุเหล็ก ทองแดง โซเดียม โพแทสเซียม แคลเซียม ฯลฯ ซึ่งส่วนใหญ่มาจากอุปกรณ์ สารเคมี และการสัมผัสของมนุษย์
-
ในสารกึ่งตัวนำ ไอออนโลหะเป็นสารปนเปื้อนที่ "ร้ายกาจ" เพราะจะทำให้เกิดระดับพลังงานในแถบพลังงานต้องห้าม ซึ่งจะเพิ่มกระแสรั่วไหล ลดอายุการใช้งานของตัวนำ และทำลายคุณสมบัติทางไฟฟ้าอย่างรุนแรง ในแก้ว ไอออนโลหะอาจส่งผลต่อคุณภาพและการยึดเกาะของฟิล์มบางที่ผลิตขึ้นในภายหลัง
-
-
ชั้นออกไซด์ธรรมชาติ
-
สำหรับแผ่นเวเฟอร์ซิลิคอน: ชั้นบางๆ ของซิลิคอนไดออกไซด์ (ออกไซด์ธรรมชาติ) จะก่อตัวขึ้นเองตามธรรมชาติบนพื้นผิวในอากาศ ความหนาและความสม่ำเสมอของชั้นออกไซด์นี้ควบคุมได้ยาก และต้องกำจัดออกให้หมดในระหว่างการผลิตโครงสร้างสำคัญ เช่น ออกไซด์ของเกต
-
สำหรับแผ่นเวเฟอร์แก้ว: ตัวแก้วเองมีโครงสร้างเป็นเครือข่ายซิลิกา ดังนั้นจึงไม่มีปัญหาเรื่อง "การกำจัดชั้นออกไซด์ดั้งเดิม" อย่างไรก็ตาม พื้นผิวอาจมีการเปลี่ยนแปลงเนื่องจากการปนเปื้อน และจำเป็นต้องกำจัดชั้นนี้ออกไป
-

I. เป้าหมายหลัก: ความแตกต่างระหว่างประสิทธิภาพทางไฟฟ้าและความสมบูรณ์แบบทางกายภาพ
-
แผ่นเวเฟอร์ซิลิคอน
-
เป้าหมายหลักของการทำความสะอาดคือการรับประกันประสิทธิภาพทางไฟฟ้า โดยทั่วไปแล้วข้อกำหนดจะรวมถึงจำนวนและขนาดของอนุภาคที่เข้มงวด (เช่น อนุภาคที่มีขนาด ≥0.1 μm ต้องถูกกำจัดออกอย่างมีประสิทธิภาพ) ความเข้มข้นของไอออนโลหะ (เช่น Fe, Cu ต้องถูกควบคุมให้ต่ำกว่าหรือเท่ากับ 10¹⁰ อะตอม/cm²) และระดับของสารตกค้างอินทรีย์ แม้แต่การปนเปื้อนในระดับจุลภาคก็อาจนำไปสู่การลัดวงจร กระแสรั่ว หรือความเสียหายของความสมบูรณ์ของออกไซด์ที่ประตูได้
-
-
แผ่นเวเฟอร์แก้ว
-
ในฐานะวัสดุตั้งต้น ข้อกำหนดหลักคือความสมบูรณ์แบบทางกายภาพและความเสถียรทางเคมี ข้อกำหนดเฉพาะมุ่งเน้นไปที่แง่มุมระดับมหภาค เช่น การไม่มีรอยขีดข่วน คราบสกปรกที่ไม่สามารถขจัดออกได้ และการรักษาความหยาบและรูปทรงของพื้นผิวเดิม เป้าหมายหลักของการทำความสะอาดคือเพื่อให้แน่ใจว่าพื้นผิวสะอาดและมีการยึดเกาะที่ดีสำหรับกระบวนการต่อไป เช่น การเคลือบผิว
-
II. ลักษณะของวัสดุ: ความแตกต่างพื้นฐานระหว่างผลึกและอสัณฐาน
-
ซิลิคอน
-
ซิลิคอนเป็นวัสดุผลึก และพื้นผิวของมันจะเกิดชั้นออกไซด์ซิลิคอนไดออกไซด์ (SiO₂) ที่ไม่สม่ำเสมอขึ้นเองตามธรรมชาติ ชั้นออกไซด์นี้เป็นอันตรายต่อประสิทธิภาพทางไฟฟ้าและต้องกำจัดออกให้หมดและสม่ำเสมอ
-
-
กระจก
-
แก้วเป็นโครงข่ายซิลิกาอสัณฐาน วัสดุหลักของแก้วมีองค์ประกอบคล้ายกับชั้นซิลิคอนออกไซด์ของซิลิคอน ซึ่งหมายความว่ามันสามารถถูกกัดกร่อนได้อย่างรวดเร็วด้วยกรดไฮโดรฟลูออริก (HF) และยังไวต่อการกัดกร่อนจากด่างเข้มข้น ทำให้พื้นผิวขรุขระหรือเสียรูปมากขึ้น ความแตกต่างพื้นฐานนี้ทำให้การทำความสะอาดแผ่นเวเฟอร์ซิลิคอนสามารถทนต่อการกัดกร่อนเบาๆ ที่ควบคุมได้เพื่อกำจัดสิ่งปนเปื้อน ในขณะที่การทำความสะอาดแผ่นเวเฟอร์แก้วต้องทำด้วยความระมัดระวังอย่างยิ่งเพื่อหลีกเลี่ยงการทำลายวัสดุพื้นฐาน
-
| อุปกรณ์ทำความสะอาด | การทำความสะอาดแผ่นเวเฟอร์ซิลิคอน | การทำความสะอาดแผ่นเวเฟอร์แก้ว |
|---|---|---|
| เป้าหมายการทำความสะอาด | รวมถึงชั้นออกไซด์ธรรมชาติของมันเองด้วย | เลือกวิธีการทำความสะอาด: กำจัดสิ่งปนเปื้อนพร้อมทั้งปกป้องวัสดุพื้นฐาน |
| การทำความสะอาด RCA มาตรฐาน | - ส.พ.(H₂SO₄/H₂O₂): กำจัดสารตกค้างอินทรีย์/สารไวแสง | ขั้นตอนการทำความสะอาดหลัก: |
| - เอสซี1(NH₄OH/H₂O₂/H₂O): กำจัดอนุภาคบนพื้นผิว | น้ำยาทำความสะอาดด่างอ่อน: มีสารลดแรงตึงผิวที่ช่วยขจัดสิ่งปนเปื้อนอินทรีย์และอนุภาคต่างๆ | |
| - ดีเอชเอฟ(กรดไฮโดรฟลูออริก): กำจัดชั้นออกไซด์ตามธรรมชาติและสิ่งปนเปื้อนอื่นๆ | น้ำยาทำความสะอาดที่มีความเป็นด่างสูงหรือด่างปานกลางใช้สำหรับกำจัดสารปนเปื้อนที่เป็นโลหะหรือสารที่ไม่ระเหย | |
| - เอสซี2(HCl/H₂O₂/H₂O): กำจัดสารปนเปื้อนที่เป็นโลหะ | หลีกเลี่ยง HF ตลอดเวลา | |
| สารเคมีสำคัญ | กรดแก่ ด่างแก่ ตัวทำละลายออกซิไดซ์ | น้ำยาทำความสะอาดด่างอ่อน สูตรเฉพาะสำหรับการขจัดคราบสกปรกเล็กน้อย |
| อุปกรณ์ช่วยเหลือทางกายภาพ | น้ำปราศจากไอออน (สำหรับล้างให้สะอาดบริสุทธิ์สูง) | การล้างด้วยคลื่นอัลตราโซนิคและเมกะโซนิก |
| เทคโนโลยีการอบแห้ง | เมกาโซนิก, การอบแห้งด้วยไอน้ำ IPA | การอบแห้งอย่างอ่อนโยน: ยกขึ้นอย่างช้าๆ แล้วอบแห้งด้วยไอน้ำ IPA |
III. การเปรียบเทียบน้ำยาทำความสะอาด
โดยพิจารณาจากเป้าหมายและคุณลักษณะของวัสดุที่กล่าวมาข้างต้น สารละลายสำหรับทำความสะอาดแผ่นเวเฟอร์ซิลิคอนและแก้วจึงแตกต่างกัน:
| การทำความสะอาดแผ่นเวเฟอร์ซิลิคอน | การทำความสะอาดแผ่นเวเฟอร์แก้ว | |
|---|---|---|
| วัตถุประสงค์ในการทำความสะอาด | การกำจัดอย่างละเอียด รวมถึงชั้นออกไซด์ดั้งเดิมของเวเฟอร์ด้วย | การกำจัดแบบเลือกสรร: กำจัดสิ่งปนเปื้อนพร้อมทั้งปกป้องพื้นผิว |
| กระบวนการทั่วไป | มาตรฐานการทำความสะอาดแบบ RCA:•ส.พ.(H₂SO₄/H₂O₂): กำจัดสารอินทรีย์หนัก/สารต้านทานแสง •เอสซี1(NH₄OH/H₂O₂/H₂O): การกำจัดอนุภาคด่าง •ดีเอชเอฟ(HF เจือจาง): กำจัดชั้นออกไซด์และโลหะที่เกิดขึ้นตามธรรมชาติ •เอสซี2(HCl/H₂O₂/H₂O): กำจัดไอออนโลหะ | ขั้นตอนการทำความสะอาดโดยทั่วไป:•น้ำยาทำความสะอาดด่างอ่อนๆโดยใช้สารลดแรงตึงผิวเพื่อกำจัดสารอินทรีย์และอนุภาคต่างๆ •น้ำยาทำความสะอาดที่เป็นกรดหรือเป็นกลางสำหรับการกำจัดไอออนโลหะและสารปนเปื้อนเฉพาะอื่นๆ •หลีกเลี่ยงการใช้ HF ตลอดกระบวนการ |
| สารเคมีสำคัญ | กรดแก่, สารออกซิไดซ์แรง, สารละลายด่าง | น้ำยาทำความสะอาดที่มีฤทธิ์เป็นด่างอ่อนๆ; น้ำยาทำความสะอาดเฉพาะทางที่เป็นกลางหรือเป็นกรดอ่อนๆ |
| การช่วยเหลือทางกายภาพ | เมกะโซนิก (การกำจัดอนุภาคอย่างมีประสิทธิภาพและอ่อนโยน) | อัลตราโซนิก เมกะโซนิก |
| การอบแห้ง | การอบแห้ง Marangoni; การทำแห้งด้วยไอไอพีเอ | การอบแห้งแบบดึงช้า; การอบแห้งด้วยไอน้ำ IPA |
-
กระบวนการทำความสะอาดแผ่นเวเฟอร์แก้ว
-
ปัจจุบัน โรงงานแปรรูปแก้วส่วนใหญ่ใช้กระบวนการทำความสะอาดโดยพิจารณาจากคุณสมบัติของวัสดุแก้ว โดยอาศัยสารทำความสะอาดที่มีฤทธิ์เป็นด่างอ่อนเป็นหลัก
-
คุณลักษณะของสารทำความสะอาด:สารทำความสะอาดเฉพาะทางเหล่านี้มักมีฤทธิ์เป็นด่างอ่อนๆ โดยมีค่า pH ประมาณ 8-9 โดยทั่วไปจะมีส่วนประกอบของสารลดแรงตึงผิว (เช่น อัลคิลโพลีออกซีเอทิลีนอีเทอร์) สารคีเลตโลหะ (เช่น HEDP) และสารช่วยทำความสะอาดอินทรีย์ ซึ่งออกแบบมาเพื่อทำให้สารปนเปื้อนอินทรีย์ เช่น คราบน้ำมันและรอยนิ้วมือ แตกตัวเป็นอิมัลชันและย่อยสลายไปพร้อมๆ กับการกัดกร่อนเนื้อแก้วให้น้อยที่สุด
-
ขั้นตอนการทำงาน:กระบวนการทำความสะอาดทั่วไปเกี่ยวข้องกับการใช้สารทำความสะอาดที่เป็นด่างอ่อนๆ ในความเข้มข้นที่กำหนด ที่อุณหภูมิตั้งแต่ระดับอุณหภูมิห้องถึง 60°C ร่วมกับการทำความสะอาดด้วยคลื่นอัลตราโซนิค หลังจากทำความสะอาดแล้ว แผ่นเวเฟอร์จะผ่านขั้นตอนการล้างหลายครั้งด้วยน้ำบริสุทธิ์และการอบแห้งอย่างอ่อนโยน (เช่น การยกขึ้นอย่างช้าๆ หรือการอบแห้งด้วยไอระเหย IPA) กระบวนการนี้สามารถตอบสนองความต้องการด้านความสะอาดที่มองเห็นได้และความสะอาดโดยทั่วไปของแผ่นเวเฟอร์แก้วได้อย่างมีประสิทธิภาพ
-
-
กระบวนการทำความสะอาดแผ่นเวเฟอร์ซิลิคอน
-
ในกระบวนการผลิตเซมิคอนดักเตอร์ โดยทั่วไปแล้วแผ่นเวเฟอร์ซิลิคอนจะผ่านกระบวนการทำความสะอาดแบบ RCA มาตรฐาน ซึ่งเป็นวิธีการทำความสะอาดที่มีประสิทธิภาพสูง สามารถกำจัดสิ่งปนเปื้อนทุกประเภทได้อย่างเป็นระบบ ทำให้มั่นใจได้ว่าตรงตามข้อกำหนดด้านประสิทธิภาพทางไฟฟ้าของอุปกรณ์เซมิคอนดักเตอร์
-
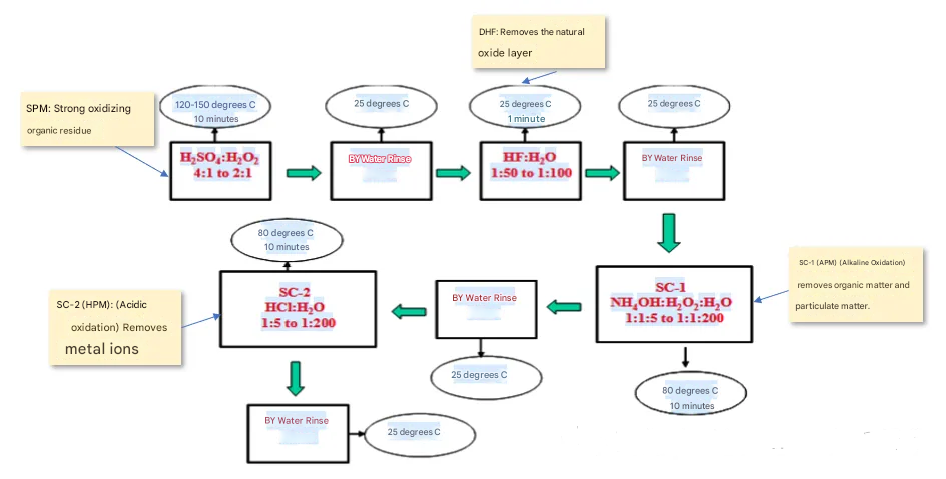
IV. เมื่อกระจกมีมาตรฐาน “ความสะอาด” ที่สูงขึ้น
เมื่อแผ่นเวเฟอร์แก้วถูกนำไปใช้ในงานที่ต้องการจำนวนอนุภาคและระดับไอออนโลหะที่เข้มงวด (เช่น เป็นวัสดุตั้งต้นในกระบวนการผลิตเซมิคอนดักเตอร์ หรือเป็นพื้นผิวสำหรับการตกตะกอนฟิล์มบางที่มีประสิทธิภาพสูง) กระบวนการทำความสะอาดแบบดั้งเดิมอาจไม่เพียงพออีกต่อไป ในกรณีนี้ สามารถนำหลักการทำความสะอาดเซมิคอนดักเตอร์มาประยุกต์ใช้ได้ โดยการนำกลยุทธ์การทำความสะอาดแบบ RCA ที่ได้รับการปรับปรุงมาใช้
หัวใจสำคัญของกลยุทธ์นี้คือการลดทอนและปรับพารามิเตอร์กระบวนการ RCA มาตรฐานให้เหมาะสมกับลักษณะที่ละเอียดอ่อนของแก้ว:
-
การกำจัดสารปนเปื้อนอินทรีย์:สารละลาย SPM หรือน้ำโอโซนชนิดอ่อนสามารถใช้ในการย่อยสลายสารปนเปื้อนอินทรีย์ผ่านกระบวนการออกซิเดชันที่รุนแรงได้
-
การกำจัดอนุภาค:สารละลาย SC1 ที่เจือจางมากจะถูกนำมาใช้ที่อุณหภูมิต่ำและระยะเวลาการบำบัดที่สั้นกว่า เพื่อใช้ประโยชน์จากแรงผลักทางไฟฟ้าสถิตและผลกระทบของการกัดเซาะระดับจุลภาคในการกำจัดอนุภาค ในขณะเดียวกันก็ลดการกัดกร่อนบนกระจกให้น้อยที่สุด
-
การกำจัดไอออนโลหะ:สารละลาย SC2 ที่เจือจาง หรือสารละลายกรดไฮโดรคลอริกเจือจาง/กรดไนตริกเจือจาง ถูกนำมาใช้เพื่อกำจัดสารปนเปื้อนโลหะผ่านกระบวนการคีเลชัน
-
ข้อห้ามที่เข้มงวด:ต้องหลีกเลี่ยงการใช้ DHF (ไดแอมโมเนียมฟลูออไรด์) อย่างเด็ดขาด เพื่อป้องกันการกัดกร่อนของพื้นผิวแก้ว
ในกระบวนการปรับปรุงทั้งหมด การผสมผสานเทคโนโลยีเมกะโซนิกช่วยเพิ่มประสิทธิภาพในการกำจัดอนุภาคขนาดนาโนได้อย่างมาก และยังอ่อนโยนต่อพื้นผิวมากกว่าเดิมด้วย
บทสรุป
กระบวนการทำความสะอาดแผ่นเวเฟอร์ซิลิคอนและแก้วเป็นผลลัพธ์ที่หลีกเลี่ยงไม่ได้ของการวิศวกรรมย้อนกลับโดยอิงจากข้อกำหนดการใช้งานขั้นสุดท้าย คุณสมบัติของวัสดุ และลักษณะทางกายภาพและเคมี การทำความสะอาดแผ่นเวเฟอร์ซิลิคอนมุ่งเน้นที่ “ความสะอาดระดับอะตอม” เพื่อประสิทธิภาพทางไฟฟ้า ในขณะที่การทำความสะอาดแผ่นเวเฟอร์แก้วมุ่งเน้นไปที่การทำให้พื้นผิว “สมบูรณ์แบบและไม่เสียหาย” เนื่องจากแผ่นเวเฟอร์แก้วถูกนำมาใช้มากขึ้นในงานด้านเซมิคอนดักเตอร์ กระบวนการทำความสะอาดจึงจะพัฒนาไปไกลกว่าการทำความสะอาดด้วยด่างอ่อนแบบดั้งเดิม โดยพัฒนาวิธีการแก้ปัญหาที่ละเอียดและเฉพาะเจาะจงมากขึ้น เช่น กระบวนการ RCA ที่ได้รับการปรับปรุง เพื่อให้ได้มาตรฐานความสะอาดที่สูงขึ้น
วันที่เผยแพร่: 29 ตุลาคม 2568
